英飛凌宣布推出全球最薄硅功率晶圓,成功將其硅功率晶圓的厚度減半至20微米(μm)。
據英飛凌電源和傳感器系統部門的Adam White介紹,與傳統硅晶圓相比,這種20微米的功率晶圓厚度減少了50%,基板電阻也相應降低了50%,進而使功率系統中的功率損耗減少了15%以上。
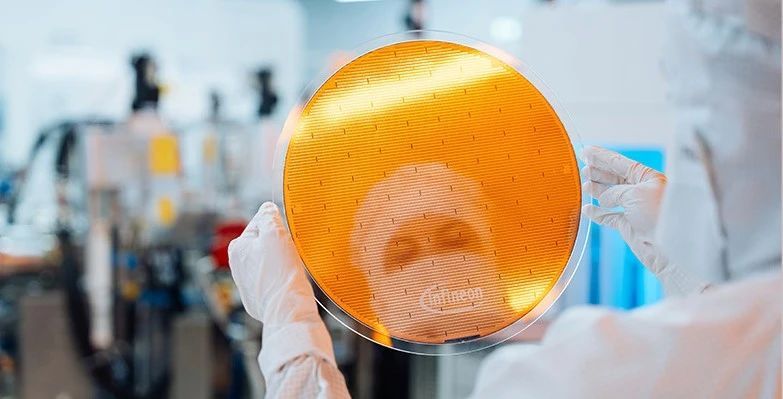
厚度20μm僅為頭發絲的四分之一,是目前最先進的40-60μm晶圓厚度的一半。該技術已獲得認可,并被應用于英飛凌的集成智能功率級(直流-直流轉換器)中,且已交付給首批客戶。厚度改進對于高端AI服務器應用尤為重要,因為隨著電流增大,能源需求也隨之上升。通過將電壓從230V降低到1.8V以下的處理器電壓,超薄晶圓技術大大促進了基于垂直溝槽MOSFET技術的垂直功率傳輸設計,實現了與AI芯片處理器的高度緊密連接,從而提高了整體效率。White表示,這種超薄晶圓將主要應用于12V器件,用于下一代AI GPU、TPU和具有垂直功率的CPU的本地電源轉換。這些器件需要在0.8V電壓下提供1000至2000A的大電流,而超薄晶圓技術通過降低RDSon(導通電阻)40%,使得這些器件在性能上有了顯著提升。White指出,這一技術突破將引起40V及以下行業的極大興趣,并已經與AI客戶進行了深入互動。此外,該技術還可應用于消費電子、電機控制和計算等領域。在談到超薄晶圓的處理技術時,White表示,300毫米晶圓的系統和處理是面臨的主要挑戰之一。然而,英飛凌通過遵循特殊步驟和增加工藝步驟,成功克服了這些障礙。與2016年推出的40微米晶圓相比,新的20微米晶圓工藝雖然增加了步驟,但并沒有引入額外的復雜性或資本支出。White強調,硅襯底上的加工過程非常出色,使得這一技術突破得以實現。 此外,White還透露,英飛凌正在掌握硅、碳化硅(SiC)和氮化鎵(GaN)這三種關鍵技術。他指出,硅將繼續在許多領域占據主導地位,但英飛凌也在積極推進SiC和GaN技術的發展。在SiC方面,英飛凌正在提升其200毫米晶圓產能;而在GaN方面,英飛凌已經宣布了世界上第一個300毫米GaN功率晶圓,該晶圓具有高頻優勢,適用于5MHz以上的應用。




